对未来五年我国电子铜箔业产品技术攻关课题的讨论
对未来五年我国电子铜箔业产品技术攻关课题的讨论
中电材协电子铜箔分会顾问 祝大同
1.前言
近两、三年,5G通信技术、人工智能应用技术、物联网及互联网技术得到广泛应用与发展。驱动了PCB朝着高速高频化、高耐热、薄型及高密度化等方向快速发展。一个新时代的技术发展,需要一代新的材料作为支撑。这一新时代的技术上的变革、发展,更加需要电子铜箔在PCB的高频信号完整性(SI)、散热性、可靠性、多功能性等各方面发挥更重要的、不可替代的作用。电子铜箔的上下游产业链在技术、市场上的新发展,也驱使我国电子铜箔制造业要急切需要解决的担负重任,在产品品种上升级换代,在产品技术上向着高端、特殊化方面的转型。
我国作为全球电子铜箔生产和消费第一大国,但在当前,电子铜箔产业上仍存在着电子铜箔业技术研究与产品开发存在着严重的不足。国内电子信息产品用的许多高、新、特的电子铜箔仍然依赖大量进口。解决高端、特殊的电子铜箔的全面国产化的配套,成为当务之急。
在未来几年中,在高频高速铜箔、IC封装载体基板用铜箔、高密度互连(HDI)多层板用铜箔、高端挠性PCB用铜箔、具有特殊的规格及功能的铜箔等,市场需要将有显著增长。
同时,随着在新能源汽车动力电池(锂电池)、储能设备用锂电池、3C电子产品用锂电池等领域的高速发展,对作为锂电池负极集电体的电子铜箔(含电解铜箔、压延铜箔)的需求量迅速增加,对它的薄形化、高强度、高可靠性的性能需求也得到迅速的提升。我国电子铜箔产业在发展锂电池铜箔的技术、品种方面,肩负重任,需努力创新践行!
未来3~5年,是我国电解铜箔业产品技术攻关,不仅表现在产品形式、性能及功能等特点的多样化方面,还需在精确对位需求市场、实现有我国自有创新特点的发展。
笔者认为,在选定我国电子铜箔业产品技术攻关课题项目中,应该遵照以下三点原则:
(1)它的自有知识产权的技术先进性,与位于全球业界的创新前沿性。创新产品,在性能及市场对位上,具有较鲜明的个性化的特点。
(2)同时也考虑到,新产品需有一定规模的需求市场,具有较强的市场生命力。
(3)特别重注了那些紧迫需要国产化配套的项目.而它们需具备有与海外同行同类产品的竞争力,以此来补国内下游需求的“短板”。
2.刚性电子电路用电解铜箔项目
2.1高频高速性刚性PCB用低轮廓反转型(Ⅱ)电解铜箔(Rz≤2.5型RTF2铜箔)
应用领域:低损耗(Low Loss)等级高频高速电路用覆铜板(Df:0.005~0.008 @10GHz)及对应的多层板制造用市场[也少量使用于极低损耗(Very Low Loss)等级高频高速电路用覆铜板]。
Rz≤2.5型RTF2铜箔主要性能: Rz ≤2.5~>2.0 μm(≈Rq 0.9~0.5μm)(压合面,18um);Rz≤3.5um(非压合面,18um)。延伸率(18um):at180℃ ≥5%;抗拉强度(18um) ≥400N/mm2。
Rz≤2.5型RTF2铜箔主要对标产品牌号:三井金属MLS-G2 ≤2.3(产品指标值);MLS-G ≤3.0(产品指标值),抗拉强度(18um)370N/mm2;苏州福田 TGFB-DSTF(L) Rz=2.5μm(典型值)。
市场上同类同档次的其它牌号:海外企业中已形成批量生产,并有一定市场占有率的牌号还有:苏州福田T9LA-DSTF(L) 、金居开发RG311、长春化工 RTF-25、台湾南亚 TLC-H1。
2.2高频高速性挠性PCB用低轮廓反转型(Ⅲ)电解铜箔(Rz≤2.0型RTF3铜箔)
应用领域:主要为高频高速特性的FPC。也可应用于极低损耗(Very Low Loss)等级高频高速电路用覆铜板(Df:0.002~0.005 @10GHz)及对应的多层板制造用。RTF3铜箔是一种在近一、两年中问世的更新型的、市场需求的反转型电解铜箔。
Rz≤2.0型RTF3铜箔主要性能:Rz ≤2.0um;抗拉强度:≥500N/mm2;厚度规格:7、9、12um。
Rz≤2.0型RTF3铜箔主要对标产品:三井金属3EC-MLS-VLP Rz=1.8um(典型值)。具有高抗张强度(≥500N/mm2),薄形化(最低厚度规格7um)。三井金属MLS-G2(Ⅱ),Rz≤2.0um(典型值,环保型).
市场上同类同档次的其它牌号:无。
2.3高频高速性刚性PCB用HVLP1型低轮廓电解铜箔(Rz≤2.0型HVLP1铜箔)
应用领域:在低损耗(Low Loss)、极低损耗(Very Low Loss)等级的高频高速电路用覆铜板,及对应的多层板制造中有的广泛应用。并在光模块基板、功率放大器、射频天线、高端服务器等应用。已在高频特性的IC封装载板中得到应用。
Rz≤2.0型HVLP1型铜箔主要性能: Rz ≤2.0~>1.5um (≈Rq 0.7~0.5um)。抗拉强度(18um) ≥350N/mm2。剥离强度(PS)(18um)≥1.2 N/mm(6.7Lb/in)(以PTFE树脂基材压合测试表征,板材厚度≥0.6mm),或PS(18um)≥0.9kg/cm(以非PTFE树脂基材压合测试表征,板材厚度≥0.6mm)。
Rz≤2.0型HVLP1型铜箔主要对标产品牌号:三井金属HS-VSP Rz≤2.0um(产品指标)、Rz=1.8um(产品典型指标),PS(18um)≥0.9kg/cm ;卢森堡电路BF-HFA,Rz≤ 2.5um(产品指标),PS值(PS)≥1.2 N/mm(6.7Lb/in)(PTFE基材)。
市场上同类同档次的其它牌号:
① 应用于刚性PCB品种牌号:古河电工FT2-UP ,Rz≤1.7um(产品指标);台湾南亚 TLC-V1;金居开发VL410(HVLP)。
②应用于模块基板、封装载板品种牌号:三井金属3EC-M2S-VLP,Rz≤1.8um(典型值);210℃/1h后的抗拉强度51kgf/mm2;延伸率4.6%。日进LPF,Rz≤1.72um(典型值),210℃/1h后的抗拉强度52.3kgf/mm2;延伸率3.7%。
2.4高频高速性刚性PCB用HVLP2型低轮廓电解铜箔(Rz≤1.5型HVLP2铜箔)
应用领域:在极低损耗(Very Low Loss)、超低损耗(Ultra Low Loss)
等级的高频高速电路用覆铜板,以及对应的多层板制造中应用。在PCB及CCL的信号完整性(Signal Integrity,SI)有更高要求的高端、高可靠性的射频-微波基板,高速数字信号基板中采用。也已在高频特性的IC封装载板中得到应用。
此类型铜箔,还在进一步在压合面涂布胶膜,或进行表面化学处理方面的应用(例:Rogers的“CU4000 LoPro”铜箔,松下的“CuTAP”铜箔)。
Rz≤1.5型HVLP2型铜箔主要性能: 压合面Rz ≤1.5~>1.0um (≈Rq 0.3um~), 非压合面Rz ≤2.5um。抗拉强度(18um) ≥350N/mm2。剥离强度(PS)(18um)≥0.8kg/cm(以非PTFE树脂基材压合测试表征,板材厚度≥0.6mm)。
射频-微波电路基板用铜箔,其表面处理需采用纯铜处理工艺,以支持减少无源互调(Passive Inter-modulation,简称PIM),实现覆铜板的低PIM性,参考指标:达到-158dBc~-160dBc以下。铜箔处理层实现无砷化。
Rz≤1.5型HVLP2型铜箔主要对标产品牌号:三井金属HS1-VSP Rz≤1.5um(产品指标)、Rz=1.2um(产品典型指标),延伸率(常态)≥8%,抗拉强度(18um)≥350N/mm2,PS(18um)≥0.8kg/cm。古河电工FT1-UP ,Rz≤1.4um(产品指标),延伸率(常态)≥15%,抗拉强度(18um) ≥320MPa。
市场上同类同档次的其它牌号:
① 应用于刚性PCB的品种牌号:福田金属FLEQ-VR(专供PTFE型CCL);福田金属T49A-DS-HD2 ;长春化工 VFP-111。
② 应用于模块基板、封装载板品种牌号:日进VLP,Rz≤1.4um(典型值),Rz≤2.0um(产品指标值)。
2.5高频高速性刚性PCB用HVLP3型低轮廓电解铜箔(Rz≤1.0型HVLP3铜箔)
应用领域:在超低损耗(Ultra Low Loss)等级的高频高速电路用覆铜板,以及对应的多层板制造中应用。在PCB及CCL的信号完整性(Signal Integrity,SI)有更高要求的高端、高可靠性的射频-微波基板,高速数字信号基板中采用。
产品类型含有平滑铜箔或称无轮廓铜箔。
Rz≤1.0型HVLP3型铜箔主要性能: Rz ≤1.0um(典型值)。抗拉强度(18um)≥310 MPa, 延伸率(18um)≥9%, PS(18um)≥0.4N/mm(PPE树脂基材)。
铜箔表面处理需采用纯铜处理工艺,以支持减少无源互调(Passive Inter-modulation,简称PIM),实现覆铜板的低PIM性(达到-158dBc~-160dBc以下)。
Rz≤1.0型HVLP3型铜箔主要对标产品牌号:三井金属NP-VSP Rz≤1.0(产品指标),WA-VSP Rz≤1.0(产品指标);古河电工FZ-WS ≤1.1um(产品指标)。卢森堡电路BF-ANP Rz≤ 1.1um(产品指标)(适用于PTFE树脂CCL)
市场上同类同档次的其它牌号:
卢森堡电路BF-NN/BF-NN-HT: Rz≤1.1um(产品指标),延伸率(常态)7%~25%,抗拉强度(18um)≥276MPa,PS(18um)≥0.4N/mm(PPE树脂基材)。
福田金属CF-T9DA-SV/CF-T9FB-SV/ CF-T4X-SV /CF-T9DA-SV ;日进ISP/IVP;长春化工 VFP-101.
2.6大电流PCB用低轮廓电解铜箔(≥105um低轮廓度厚铜箔)
应用领域:主要用于大电流、电源基板、高散热电路板的制造。制出的厚铜PCB主要应用于汽车电子、电源供应器、大功率工业控制设备、太阳能设备等。
≥105um低轮廓厚铜箔主要性能:铜箔厚度在≥105um(3oz)的低轮廓度厚电解铜箔(含RTF铜箔)。常用规格:105、140、175、210um。铜箔抗拉强度:300N/mm2;延伸率:15%。低表面粗糙度(175um):压合面Rz≤2.5 um,非压合面Rz≤4.3um (参考指标)。低线膨胀系数CTE ≤ 22.0μm/m℃(参考指标)。
≥105um低轮廓厚铜箔主要对标产品牌号:三井金属MW-G(抗张强度:300N/mm2;延伸率:15%,低表面粗糙度)。三井金属MLS-G(Ⅱ型),Rz=2.5(典型值)(RTF型)。
市场上同类同档次的其它牌号:
① 传统品种牌号:长春化工PKS(HTE);古河电工GTS-STD;卢森堡电路铜箔TZA;南亚(Nan Ya)的NPME。
② 低轮廓品种牌号:三井金属MLS-G(Ⅱ型),Rz=2.5(典型值)【RTF型】;卢森堡电路铜箔 TW-B, Rz≤ 4.2(产品指标).
苏州福田CF-TGFB-SV/CF-TBFB-SV,Rz=1.0 um。
2.7大电流PCB用常规轮廓度超厚电解铜箔(300~400um)
应用领域:主要用于大电流、电源基板、高散热电路板的制造。制出的厚铜PCB主要应用于汽车电子、电源供应器、大功率工业控制设备、太阳能设备等。更主要用于更大电流。
常规轮廓度超厚铜箔(300~400um)主要性能:
厚度规格:350um(10oz )、400um(11.5oz);
主要技术指标:压合面( M面)粗糙度:Ra≤4um,15um≤Rz≤20um;非压合面糙度( M面):Ra≤0.4um,Rz≤3um。抗拉强度(室温):≥300n/mm2;延伸率(室温):≥17%;剥离强度:≥1.5Kg/cm。
常规轮廓度超厚铜箔(300~400um)对标产品牌号:GOULD公司JTC400、卢森堡公司TO(300~400um);
3.挠性电子电路用电子铜箔项目
3.1高频高速性FPC用低轮廓电解铜箔(Rz≤1.5型FPC用铜箔)
应用领域:应用于高频高速挠性电路板制造。终端电子产品:智能手机、平板电脑、高端携带型电子产品、穿戴型电子产品等。
高频高速性FPC用低轮廓电解铜箔主要性能:①低粗糙度:Rz≤1.5um(6um厚Cu);Rz≤1.1um(9um厚Cu);②铜箔薄型化厚度极薄形化。产品规格:6um、9um、12um;18um。③优异的机械性能:抗张强度(180℃)≥210(N/mm2),延伸率(180℃):10%(6um厚Cu)/13%(9um厚Cu);剥离强度:0.45kN/m(6um厚Cu)/0.55kN/m(9um厚Cu)。
高频高速性FPC用低轮廓电解铜箔主要对标产品牌号:
福田金属CF-T4X-SV6/ CF-T4X-SV7/CF-T4X-SV12/CF-T4X-SV18.三井金属TQ-M4-VSP Rz≤0.6(典型值);
市场上同类同档次的其它牌号:福田金属CF-T49A-DS-HD2,Rz=1.0 um(典型值)(规格6/9/12/18);三井金属3EC-MLS-VLP Rz=1.8(典型值,高抗力,薄形化:厚度最低7um);日进ISP,Rz≤0.55(典型值)。
3.2 FPC用高挠曲性、低弹性模量压延铜箔
应用领域:应用于挠性电路板(FPC),以及刚-挠性PCB(软硬结合板)制造。所制的FPC的终端产品主要是:液晶模块、HDD、光学读取、车载电子、携带型电子产品、穿戴型电子产品等。
高挠曲性、低弹性模量压延铜箔主要性能:实现高的弯折特性(静态弯曲性能)、高的滑动屈曲特性(动态弯曲性能)、低弹性模量(即低回弹性、优异的柔软性)、高耐振动性。具体达标参照JX日矿金属HA-V2箔。
高挠曲性、低弹性模量压延铜箔主要对标产品牌号:JX日矿金属HA、HA-V2箔。
市场上同类同档次的其它牌号:几乎无。
4.封装载板用基板材料项目
4.1 IC封装载板用极薄电解铜箔市场需求及其新变化
近期一篇来自海外PCB专家撰写的论文[(台)林定皓.吕洪杰等.景硕&大族:皮秒激光能否适配HDI技术的进步需求.PCB007线上杂志.2020.7],对超薄、低轮廓铜箔的应用市场及应用性能要求作了较精辟的阐述。文中提出:“自2017年后,HDI板开始大量采用在IC载板产品上已经是普遍应用的线路电镀工艺。这种工艺被称为半加成法工艺(SAP),是利用线路电镀技术,以满足IC载板小于15 μm的线路结构需求,这种工艺在一般HDI板尚未采用,不过利用超薄铜皮做半加成技术(mSAP)的调整后,已经成为HDI制造的主流工艺。”
“IC载板运用的半加成法(SAP)与类载板(SLP)的带铜箔半加成法(mSAP)的差异在于加工的板材是否是预压超薄铜箔。目前市场通常情况下,成熟的SAP工艺加工的都是ABF薄膜材料,采用全板沉铜工艺,这并不适合现存多数生产设备的设置;因此就催生了改良型方案,即带超薄铜箔的半加成工艺技术。”
文中给出了带超薄铜箔的半加成法(mSAP)的工艺路线对比图(见图1),笔者在此上标出了“预压超薄铜箔”的位置,以便读者有明晰的了解。
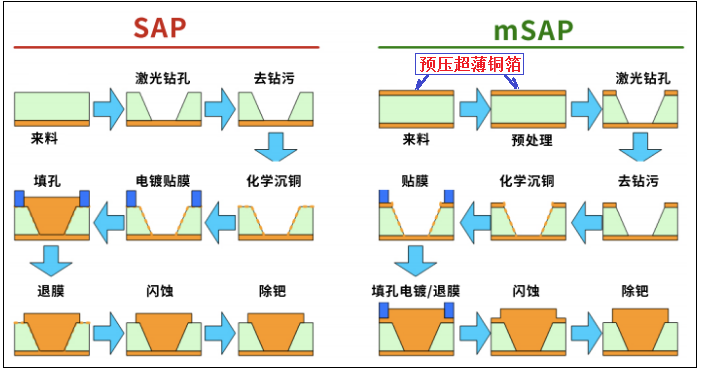
图1 SAP与mSAP的工艺流程比较
该文提出:“带铜箔半加成法工艺的关键就是使用了载体铜,这有助于铜箔的抗剥离强度稳定且加强纤维的支撑。”但是,文中也同时提到了采用压合法覆在基材上的超薄铜箔,在微细电路、微孔激光加工中所应达到的几项重要性能。它主要包括:较高的并稳定的铜箔抗剥离强度、超薄铜箔的厚度均匀性、低表面粗糙度、铜箔光面上适宜的抗氧化涂层、微细线路的蚀刻性等。其中,铜箔抗剥离强度是最重要的性能项目。
4.2 IC封装载板用无载体极薄电解铜箔(铜箔厚度≤6.0um铜箔)
应用领域及其市场需求的新变化:适用于微细线路多层PCB、微细线路类载板(SLP)及半加成法(mSAP)基板的制造的基板。所制基板类型为高端微细线路基板,以及IC封装载板、光模块基板等。国内PCB业对此类铜箔有着很强烈的需求。
IC封装载板用无载体极薄电解铜箔主要性能: 无载体厚度最低在6um的电解铜箔。具有高弹性模量、高抗张强度。
IC封装载板用无载体极薄电解铜箔主要对标产品牌号:属自主创新的品种,无完全对标产品。
4.3 IC封装载板用附载体极薄电解铜箔
应用领域:适用于多层PCB、软硬结合板介质层形成的微细线路(L/S 30~60/30~60μm)类载板(SLP)及采用化学镀的半加成工艺方法(SAP、mSAP)制造的半导体封装载板、光模块基板等。国内PCB业对此类铜箔有着很强烈的需求。
国内内资铜箔企业无此类铜箔。甚至研发工作尚在初级阶段。
IC封装载板附载体极薄电解铜箔主要性能: 无载体厚度在2~9um的电解铜箔。具有高弹性模量、高抗张强度。
IC封装载板用无载体极薄电解铜箔主要对标产品牌号:日本三井金属MT18SD-H、MT18EX。
市场上同类同档次的其它牌号:三井金属的MT18FL(有载体),Rz≤1.3um ,形成电路铜箔的规格1.5、2、3um。
日本电解的YSNAP(2μm)、古河电工的F-DP和F-HP(1.5~5μm)、日矿金属的JXUT-I(1.5、2.0、3.0μm)/Ⅱ(5μm)/Ⅲ(1.5、3.0μm)。日进材料(ILJIN Materials)LPF。
5.锂电池用电解铜箔项目
5.1极薄/高抗力型锂电池用电解铜箔
应用领域:适用于高容量、高可靠性要求的锂电池负极集电体所用。
极薄/高抗力型锂电池用电解铜箔主要性能:铜箔厚度达到 ≤6.0um。双面光型电解铜箔。具有高抗拉强度、高延伸率及抗高温耐氧化性等性能。其中抗拉强度达到550MPa以上,且在110℃条件下烘烤6小时后抗拉强度≥500MPa,延伸率(%)≥5.0(6.0um)。表面粗糙度Rz≤2.0μm。 抗高温耐氧化性:140℃/15分钟不氧化不变色。并且产品品质稳定性,产品性能的一致性。
极薄/高抗力型锂电池用电解铜箔主要对标产品牌号:古河电工NC-WC双面光型锂电池用电解铜箔(6um规格)。日本电解株式会社SEED。
5.2锂电池用网状电解铜箔
应用领域:适用于高端大容量电容、高密度锂离子电池新型负极集电体所用。
锂电池用网状电解铜箔主要性能:铜箔厚度≤15.0um,孔隙度≥20%,孔径≥0.3mm,幅宽≥600mm。具有高抗拉强度(拉张强度)、高延伸率及抗高温耐氧化性等性能。其孔径均匀、孔间距相等,微孔边缘平整,不易变形。
锂电池用网状电解铜箔主要对标产品牌号:福田金属箔粉株式会社:“锂电池用开孔金属箔”。



